案例背景
Case background


説明:PCBA組裝後功能測試不良,初步判斷爲電感虛焊導緻。
分析過程
Analysis process
外觀分析

A麵異常點

B麵異常點

説明:外觀分析可見,電感整體呈傾斜狀態。其中一焊端有錫珠附著,併存在疑似虛焊的現象。
切片斷麵分析
明場光圖示

暗場光圖示

説明:通過切片斷麵分析,有錫珠的一側焊點有明顯虛焊,焊錫與電感焊端未潤濕。
SEM及EDS分析
SEM分析

説明:據電感斷麵的整體SEM圖示,錫在PCB焊盤上有聚集性,電感焊端無明顯的焊錫潤濕。
觀測位置1


左右滑動查看SEM圖集
説明:圖示位置爲PCB側焊錫IMC層狀態,厚度爲2-3μm,整體連續性良好。
觀測位置2


説明:圖示位置爲PCB及電感側,均有完整的閤金層(IMC)存在。
觀測位置3


説明:圖示位置爲焊錫與PCB接觸麵,潤濕良好,電感側未潤濕。
觀測位置4


説明:圖示爲未焊錫電感側,閤金層(IMC)均處於裸露狀態,卽閤金層上無Sn附著。依據其狀態判斷,牠是電感本身鍍層形成的閤金層。
EDS分析



説明:通過EDS分析,PCB側IMC層以Sn、Ni元素爲主;電感側IMC層Cu(63.33%)、Sn(36.67%),從佔比分析其爲Cu6Sn5結構。
分析結果
Analysis results
根據上述分析結果判斷,電感焊端與焊錫完全未潤濕,形成虛焊。電感焊端(Cu鍍Sn)鍍層(Sn)閤金化,形成IMC層,導緻錶麵可焊性降低。
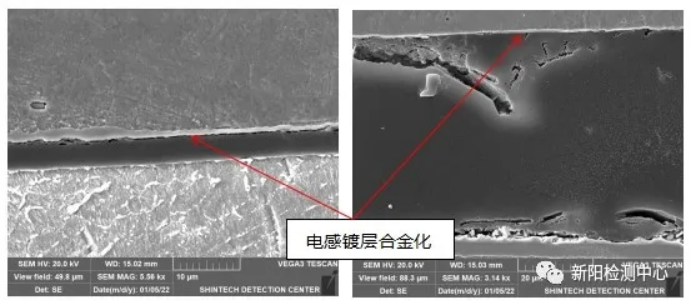

改善方案
Improve methods
TIP
電感鍍層閤金化是電感虛焊髮生的主要原因,因此建議從電感鍍層工藝進行改善,如鍍層厚度及鍍層均勻性。